新恒汇创业板IPO过会:核心产品市占率全球第二 技术创新兼顾性能要求与成本控制
3月22日,新恒汇电子股份有限公司(以下简称“新恒汇”)创业板IPO申请成功过会,即将进入注册程序。

作为国内少有的集芯片封装材料的研发、生产、销售与封装测试服务于一体的集成电路企业,新恒汇目前主要布局智能卡业务、蚀刻引线框架业务以及物联网eSIM芯片封测业务三大板块。此次踏入资本市场,新恒汇将依托募集资金进行产业升级和技术升级,谋求公司业绩未来的可持续增长。
柔性引线框架产品市占率全球第二
物联网eSIM芯片封测业务增长潜力巨大
当前,集成电路产业已成为全球信息产业的基础和核心,行业下游应用领域广泛,几乎覆盖了所有电子设备。而在集成电路的生产链条中,封装测试是最后一个环节,也是提高集成电路稳定性及制造水平的关键工序。
在人力资源成本优势、税收优惠等多重因素的推动下,全球集成电路封测产能正在逐渐向亚太地区转移。从我国的情况来看,市场规模增长明显,封装测试环节已成为我国大陆半导体产业链最为成熟和最具国际竞争力的领域。
据悉,新恒汇在智能卡模块封测业务领域深耕多年,与国内外多家知名安全芯片设计厂商及智能卡产品制造商建立了长期合作关系,所生产的柔性引线框架和智能卡模块已被广泛应用于通讯、金融、交通及身份认证等领域的智能卡产品中。
众所周知,智能卡又称集成电路卡或IC卡,是将安全芯片嵌入卡基并压制成卡片形式,再写入卡片操作系统(COS),最终实现数据的存储、传递、处理等功能。一般来说,芯片设计厂商通过与晶圆代工厂一系列合作流程完成晶圆裸片的生产,再将测试后的晶圆裸片,交由智能卡模块封装厂商,利用柔性引线框架再将安全芯片封装成智能卡模块。
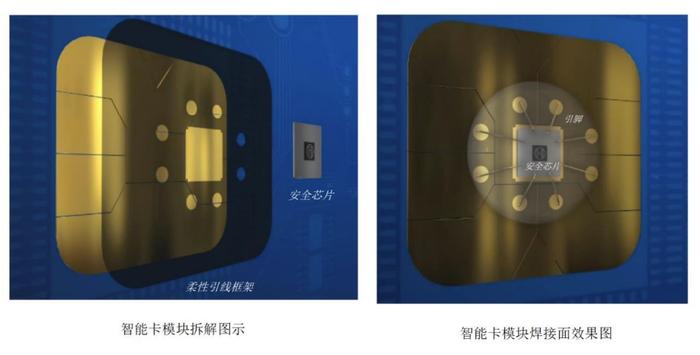
由于柔性引线框架产品的研发和生产需要长期的经验积累与严格的品质管控,行业进入壁垒较高,目前全球具备大批量稳定供货的柔性引线框架生产厂家主要有三家,新恒汇就位列其中。

根据欧洲智能卡协会(Eurosmart)发布的行业权威统计数据,最近三年全球智能卡总出货量分别为100.33亿张、95.40亿张、95.05亿张,结合公司柔性引线框架销量(包括直接和间接)简单测算,最近三年公司柔性引线框架产品的市场占有率分别为15.11%、19.94%和21.15%,仅次于法国Linxens,排名第二。
多年来的技术积累也使新恒汇能够快速切入蚀刻引线框架产品和物联网eSIM芯片封测服务领域。
蚀刻引线框架是集成电路QFN/DFN封装必需的封装材料之一,长期以来高端蚀刻引线框架主要由日韩等外资企业生产,国内自给率非常低。目前,新恒汇的蚀刻引线框架业务也已实现突破,成功供货100多家客户,下游客户主要为华天科技、甬矽电子等半导体封装厂商。
此外,公司的新业务物联网eSIM芯片封测迎合了物联网的发展趋势,满足了下游物联网厂商不断增长的需求,也是公司未来重要的收入增长点之一。
技术创新兼顾性能与成本
募投项目落地助推公司产品线拓展
先进成熟的工艺技术是新恒汇业绩快速增长的基础。
公司始终坚持自主研发,不断进行技术和工艺创新,形成了与公司经营发展需要相匹配的多项核心技术和工艺,例如贯穿冲压、贴铜、烘烤固化、前处理、压感光膜、胶片制作与曝光、显影、蚀刻、电镀、分切、机器视觉检测等多道制程。其中,公司自主研发了选择性电镀技术,对产品进行“分区域”选择性电镀,即通过模具屏蔽的方式,对产品功能区和非功能区进行分区电镀,只在功能区进行目标厚度的金属层沉积,屏蔽非功能区的金属沉积(尤其贵金属镀层),这样既可以满足产品性能要求又降低了生产成本。

值得一提的是,在蚀刻引线框架和物联网eSIM芯片封测领域,新恒汇近几年来投入大量人力、物力开展技术攻关,目前已成功掌握了包括卷式无掩膜激光直写曝光技术、卷式连续蚀刻技术及高精准选择性电镀技术等在内的多项核心技术,实现了产品的批量生产及销售。
据悉,公司曾主持制订了“集成电路(IC)卡封装框架”国家标准(GB/T19842-2021);同时也是“中国半导体行业协会金融安全IC卡芯片迁移产业促进联盟”成员单位,曾荣获党政机要密码科学技术进步奖励评审委员会颁发的“金融领域国产密码技术研究与应用示范科技进步一等奖(省部级)”等多项荣誉。
此次冲击创业板,新恒汇拟募资5.19亿元,投向高密度QFN/DFN封装材料产业化项目和研发中心扩建升级项目。

招股书显示,两大募投项目均围绕公司主营业务进行,是公司现有业务的延展和升级。高密度QFN/DFN封装材料产业化项目是在公司现有产品、技术的基础上,充分发挥公司在超大规模集成电路用蚀刻引线框架领域的技术、工艺和产品优势,购买先进生产设备,扩大生产规模,缓解产能瓶颈,提高相关产品的市场占有率。而研发中心扩建升级项目对于巩固公司现有技术优势、进一步发挥公司研发中心在技术创新和新产品研发中的作用也具有十分重要的意义。
公司表示,通过上述两个募集资金投资项目的实施,公司可实现优势产品扩产和现有工艺技术升级,为公司在集成电路封装测试领域拓展产品线、丰富产品类型奠定坚实的基础,进一步提高公司的核心竞争力。(全景网)
