台积电凭藉CoWoS占据先进封装市场,传统封测厂商如何应战?
为了满足高性能计算、AI、5G等应用需求,高阶芯片走向小芯片(Chiplet)设计、搭载HBM高带宽内存已是必然,因此封装型态也由2D迈向2.5D、3D。
随着芯片制造持续往更小的制程节点迈进,晶圆代工厂利用先进封装技术直接封装晶片的模式乃应运而生。不过,此模式也意味著晶圆代工厂将攫取传统封测厂的部分业务,所以自从台积电于2011年宣布进军先进封装领域之后,其对于传统封测厂的“威胁论”就不曾间断,那么此说法是否属实呢?
事实上,传统封测厂仍具备相当的竞争力,首先是大量电子产品仍仰赖其多元的传统封装技术。特别是近年来,在AIoT、电动车、无人机高速发展下,其所需的电子元件仍多半采用传统封装技术。其次,面对晶圆代工厂积极切入先进封装领域,传统封测厂也未有怠慢,纷纷提出具体解决方案。
传统封测厂的先进封装技术
2023年以来,AIGC迅速发展,带动AI芯片与AI服务器热潮,而由台积电推出、被称为CoWoS的2.5D先进封装技术更是扮演关键角色。然而,突如其来的需求让台积电应接不暇,面对此情况,传统封测大厂如日月光、Amkor也相继展现技术实力,并未打算在此领域缺席。
例如,日月光的FOCoS技术能整合HBM与核心运算元件,将多个芯片重组为扇出模组,再置于基板上,实现多芯片的整合。其在今年五月份发表的FOCoS-Bridge技术,则能够利用硅桥(SiBridge)来完成2.5D封装,助力打造AI、数据中心、服务器应用所需之高阶芯片。
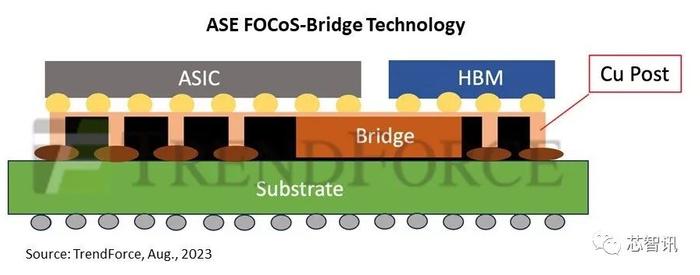
此外,日月光旗下矽品的FO-EB技术,亦是整合核心运算元件与HBM的利器,从下图来看,该技术不使用硅中介层,而是透过硅桥与重分布层(RDL)实现连结,同样能够实现2.5D封装。

而另一家封测大厂Amkor(安靠)除了与三星(Samsung)共同开发H-Cube先进封装解决方案以外,也早已布局“类CoWoS技术”,其透过中介层与TSV技术能连接不同芯片,同样具备2.5D先进封装能力。
▲Amkor技术结构图
而中国封测大厂江苏长电的XDFOI技术,则是利用TSV、RDL、微凸块技术来整合逻辑IC与HBM,面向高性能计算领域。
近来高阶GPU 芯片需求骤升,台积电CoWoS产能供不应求,NVIDIA也积极寻求第二甚至第三供应商的奥援,日月光集团已然凭藉其2.5D封装技术参与其中,而Amkor的类CoWoS技术也磨刀霍霍,足以说明传统封测大厂即便面对晶圆代工厂切入先进封装领域的威胁,仍有实力一战。
再就产品别来看,晶圆厂先进封装技术锁定一线大厂如NVIDIA、AMD;而其他非最高阶的产品,仍会选择日月光、Amkor、江苏长电等传统封测厂进行代工。整体来看,在不缺席先进封装领域,并且掌握逐步扩张之既有封装市场的情况下,传统封测大厂依旧能保有其市场竞争力。
来源:Tehcnews
