台积电组建FOPLP封装开发团队,并规划建设小型试产线
2024-07-16 12:36:09 - 资讯精选
台积电(TSMC)在2016年开发出整合扇出型封装(InFO)的扇出型晶圆级封装(FOWLP)技术,并应用于苹果iPhone7所搭载的A10处理器。随后专业封装测试厂(OSAT)业者竞相发展FOWLP及扇出型面板级封装(Fan-outPanelLevelPackage,FOPLP)技术,以提供单位成本更低的封装解决方案。
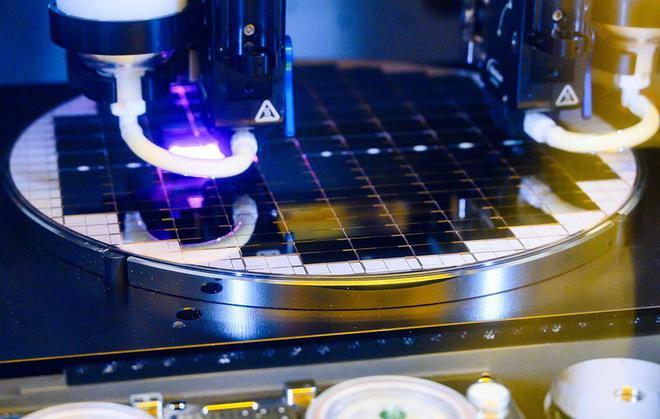
据TrendForce报道,随着人工智能(AI)等新应用需求激增,先进封装成为了一个热门的话题,其中FOPLP封装技术再次受到了关注。有业内人士透露,台积电已组建专门的团队探索FOPLP封装技术,并计划建设一条小型生产线进行试产,目标是超越传统的方法。
台积电打算先进封装技术从晶圆级过渡到面板级,而且逐渐成为现实。开发中的FOPLP可以看作是InFO的矩形版本,具有单位成本更低、封装尺寸更大的等优势。传闻台积电正在测试的矩形基板尺寸为515mmx510mm,与目前12英寸(300mm)的传统圆形晶圆相比,可用面积是其3.7倍以上,可以更好地满足市场对芯片的需求。
未来还可以进一步整合台积电3DFabric平台上的其他技术,为2.5D/3D先进封装解决方案服务于高端产品应用铺平道路。这种方法可以被视为类似于矩形CoWoS封装,目前主要针对以英伟达为主的AIGPU领域。如果进展顺利,最早可能会在2026年至2027年之间首次亮相。
