imec 首次成功利用 ASML High NA EUV 光刻机实现逻辑、DRAM 结构图案化
2024-08-08 09:42:42 - IT之家
IT之家8月8日消息,比利时微电子研究中心imec当地时间昨日宣布,在其与ASML合作的HighNAEUV光刻实验室首次成功利用HighNAEUV光刻机曝光了逻辑和DRAM的图案结构。
在逻辑图案方面,imec成功图案化了单次曝光随机逻辑机构,实现了9.5nm密集金属线(IT之家注:对应19nmPitch),将端到端间距尺寸降低至20nm以下:
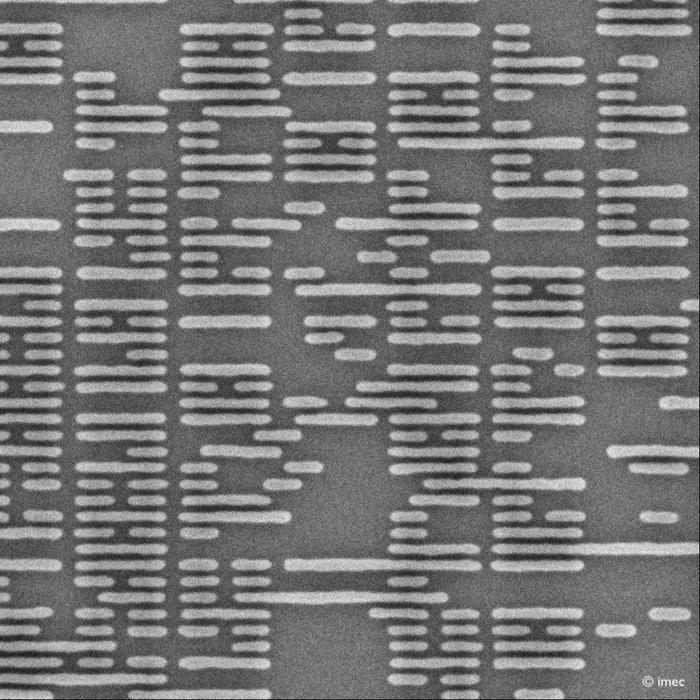
不仅如此,imec实现了中心间距30nm的随机通孔,展现了出色的图案保真度和临界尺寸一致性:

此外,imec通过HighNAEUV光刻机构建了P22nm间距的二维特征,显示了新一代光刻技术在二维布线方面的潜力:

而在DRAM领域,imec成功利用单次曝光图案化了集成SNLP(StorageNodeLandingPad)和位线外围的DRAM设计,展现了HighNAEUV减少曝光次数的能力:
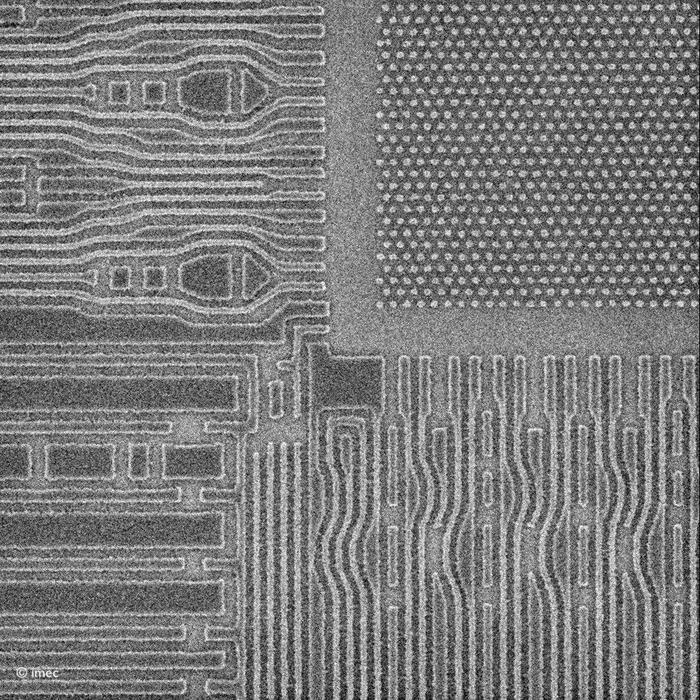
imec总裁兼首席执行官LucVandenhove表示:
这些结果证实了HighNAEUV光刻技术长期以来所预测的分辨率能力,一次曝光即可实现20nm以下间距的金属层。
因此HighNAEUV将对逻辑和存储器技术的尺寸扩展起到重要作用,而这正是将路线图推向"埃米时代"的关键支柱之一。
这些早期演示之所以能够实现,要归功于ASML-imec联合实验室的建立,它使我们的合作伙伴能够加快将HighNA光刻技术引入制造领域。
广告声明:文内含有的对外跳转链接(包括不限于超链接、二维码、口令等形式),用于传递更多信息,节省甄选时间,结果仅供参考,IT之家所有文章均包含本声明。
